服务热线
0769-28680919
153-2293-3971 / 177-0769-6579
在芯片封装的全流程中,点胶工艺主要承担着粘接、保护、导热、导电和密封五大功能。几乎所有需要将两种材料结合或保护芯片免受环境影响的环节,都会涉及到点胶。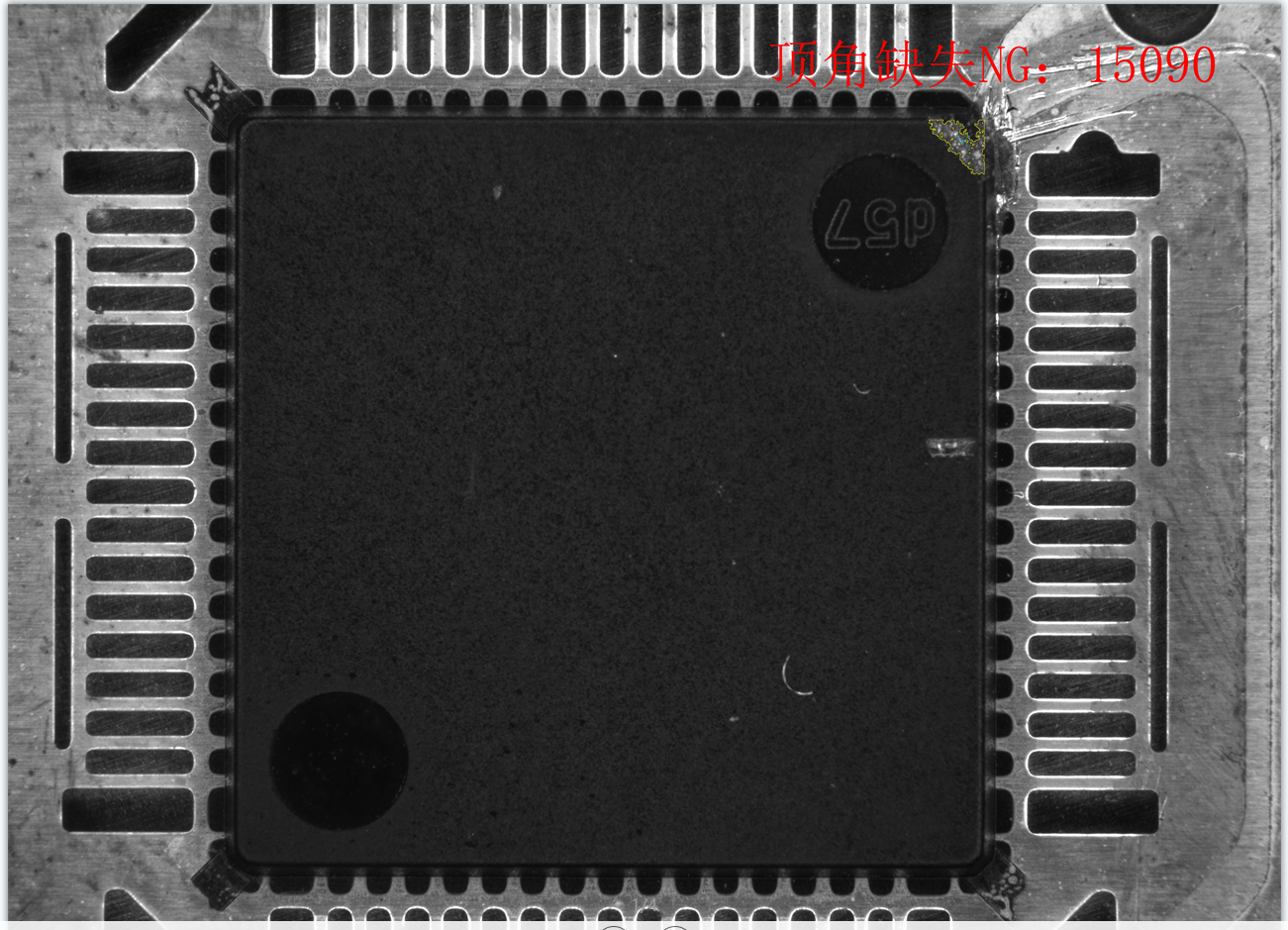
以下是芯片封装中需要点胶的核心工序及其具体作用:
1. 芯片粘接——最基础的点胶工序
这是封装中最常见的点胶环节,主要目的是将切割好的芯片固定在基板或引线框架上。
应用场景: 传统引线键合封装、堆叠式封装。
胶水类型: 环氧树脂胶、银胶。
作用:
固定: 将芯片粘贴在基板中央。
导热/导电: 如果使用的是银胶,它还负责将芯片产生的热量传导至基板,或形成芯片背面的电气连接。
2. 底部填充——倒装芯片的关键步骤
随着倒装芯片的普及,底部填充已成为保证可靠性的核心点胶工序。
应用场景: 倒装芯片、BGA(球栅阵列封装)、CSP(芯片尺寸封装)。
胶水类型: 毛细管底部填充胶、非流动填充胶。
作用:
应力缓解: 填充芯片与基板之间的间隙,包裹住微凸点,分散由于热膨胀系数不匹配产生的应力,防止焊点疲劳开裂。
机械加固: 显著提高芯片与基板的连接强度。
3. 围坝与填充——腔体封装
对于需要在芯片周围形成保护墙的封装形式,点胶需要分两步走。
应用场景: 图像传感器、MEMS(微机电系统)传感器、光模块封装。
胶水类型: 高粘度围坝胶、低粘度填充胶。
作用:
围坝: 先在芯片周围点出一圈高粘度的胶墙(类似堤坝),防止后续的液态胶水外流。
填充: 在围坝形成的腔体内注入保护胶,将芯片完全包封起来,保护敏感的金线或敏感结构,同时透光区域需要留空或使用透明胶。
4. 芯片包封/塑封前点胶
在传统的塑封料传递成型之前,有时需要先进行局部点胶。
应用场景: 异形结构保护、金线保护。
胶水类型: 液态塑封料。
作用: 在高速或大尺寸芯片上,为了防止极细的金线在后续高压塑封过程中被冲断或冲弯,会先点少量的胶水覆盖住金线根部进行局部保护。
5. 导电胶点胶——替代焊料
在某些对温度敏感或间距极细的场合,无法使用传统回流焊,改用导电胶。
应用场景: 射频识别标签、柔性电路板连接、异质集成。
胶水类型: 各向异性导电胶。
作用: 通过点胶的方式将导电胶涂布在连接盘上,通过热压实现电气导通。视觉系统在此处需要精确控制胶量,过多会导致短路,过少会导致开路。
6. 导热界面材料点胶——散热管理
在封装完成后,芯片需要与散热盖或散热器接触。
应用场景: 高性能处理器、GPU、功率器件。
胶水类型: 导热硅脂、导热凝胶。
作用: 在芯片表面与散热盖之间点涂一层导热材料,填充微观间隙,将热量高效传导出去。
7. 密封与粘盖——气密封装
对于需要隔绝水氧的芯片,需要在封装最后一步进行密封。
应用场景: 晶振、MEMS传感器、军用/宇航级芯片。
胶水类型: 低透湿环氧胶、紫外固化胶。
作用: 在金属或陶瓷盖板的边缘进行精密点胶,然后将盖子盖上并固化,形成一道物理屏障,保护内部的敏感芯片。
8. 临时键合与解键合(先进封装)
在3D封装或晶圆级封装中,有一种特殊的“涂胶”环节,虽然不是传统意义上的点胶,但原理类似。
应用场景: 晶圆减薄、TSV制造。
胶水类型: 临时键合胶。
作用: 将功能晶圆通过旋涂或点胶的方式粘附在临时载板上,以便进行背面工艺;工艺完成后,再通过化学或热方式解胶分离。
总结
芯片封装中,芯片粘接、底部填充、腔体密封是三大最主要的点胶工序。点胶的目的可以归纳为:
把芯片粘住(Die Attach)。
把缝隙填满(Underfill)。
把芯片包住(Glob Top/Dam & Fill)。
把热量导出(TIM)。
把盖子封严(Sealing)。
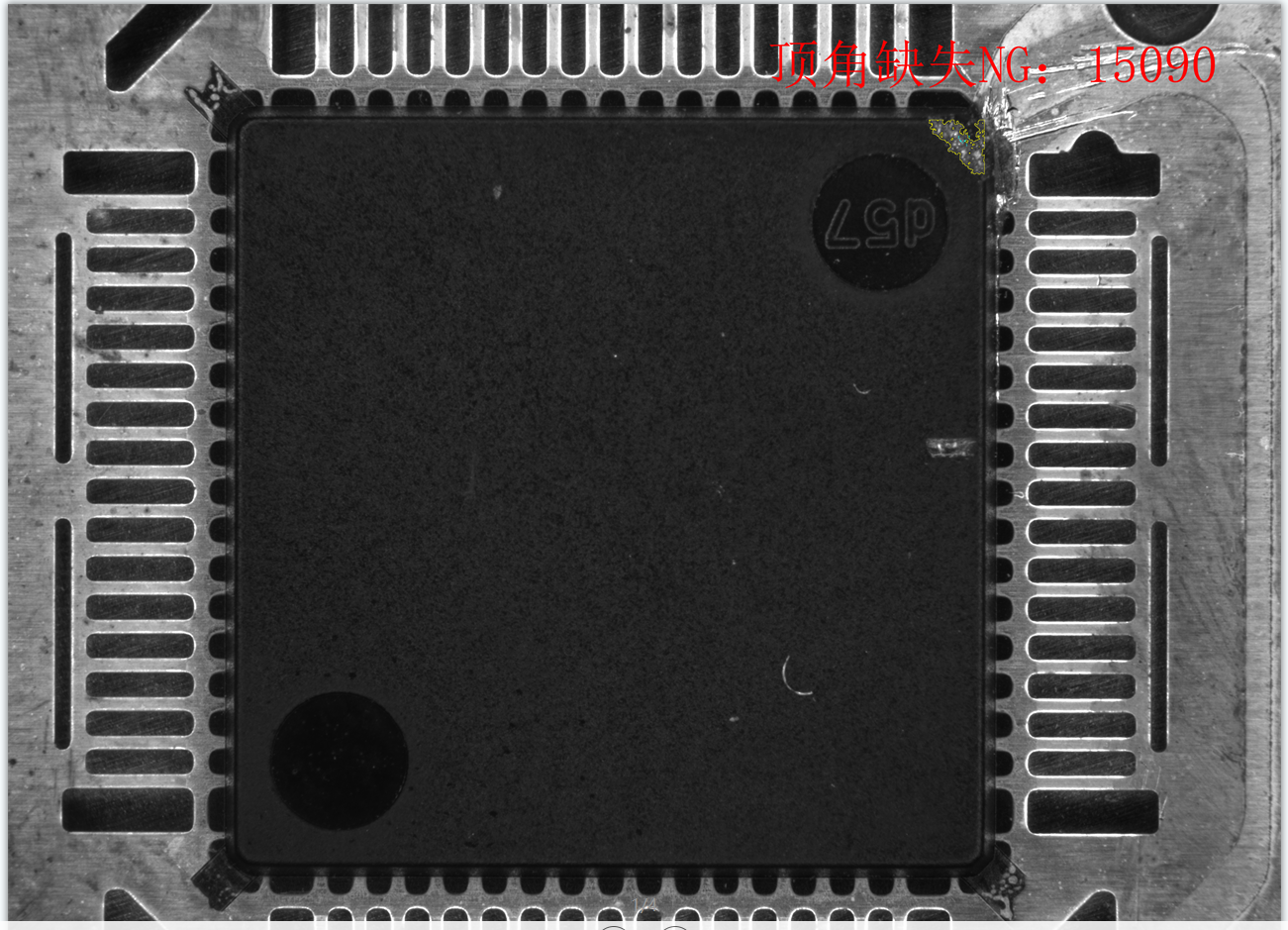 芯片封装哪些工序需要点胶
2026-03-22
芯片封装哪些工序需要点胶
2026-03-22
在芯片封装的全流程中,点胶工艺主要承担着粘接、保护、导热、导电和密封五大功能。几乎所有需要将两种材料结合或保护芯片免受环境影响的环节,都会涉及到点胶。
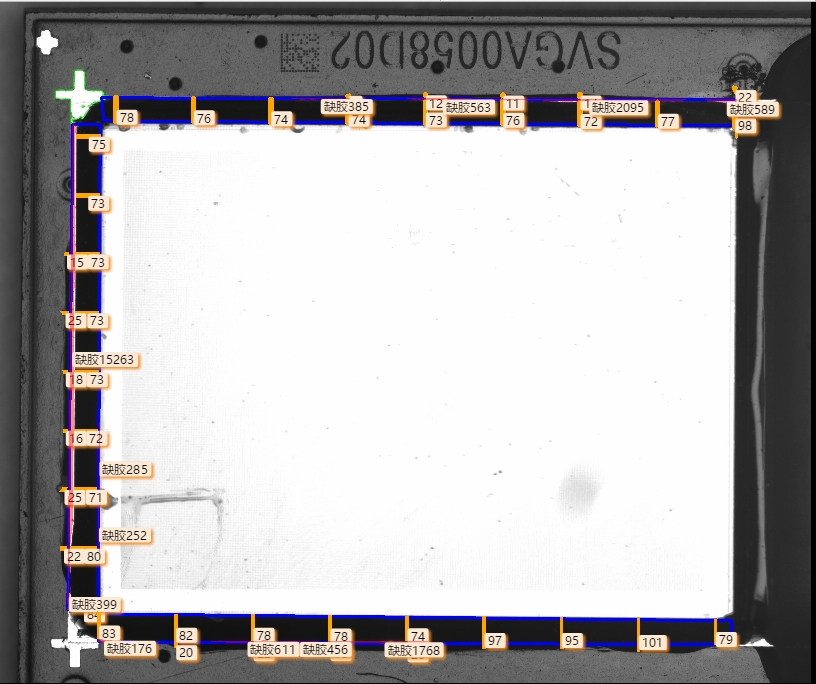 视觉系统能够应用在哪些工序的芯片封装点胶检测中
2026-03-22
视觉系统能够应用在哪些工序的芯片封装点胶检测中
2026-03-22
在芯片封装的点胶工序中,视觉系统是保证工艺质量的核心。点胶主要用于芯片粘接、底部填充、包封和精密涂覆,这些环节的缺陷往往会导致芯片功能失效。
 TWS无线耳机密封点胶缺陷视觉检测系统
2026-03-22
TWS无线耳机密封点胶缺陷视觉检测系统
2026-03-22
TWS无线耳机密封点胶缺陷视觉检测系统
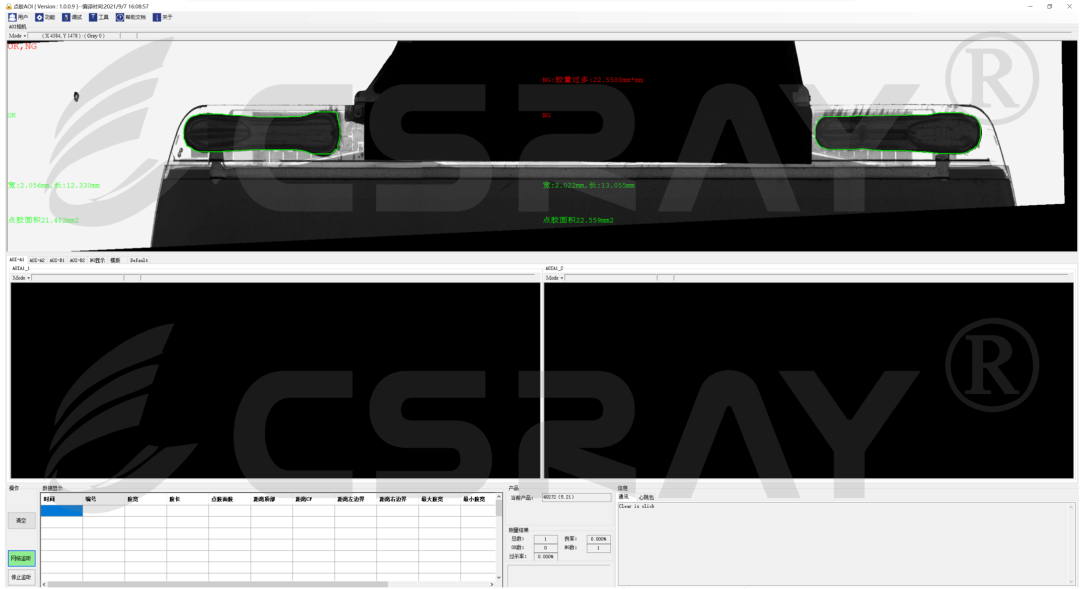 FPC胶线最终质量视觉检测
2026-03-15
FPC胶线最终质量视觉检测
2026-03-15
FPC上的胶线(通常指补强胶、粘接胶或密封胶)最终质量视觉检测是3C电子制造中非常关键的环节。由于FPC本身柔软、易变形,且胶线反光特性复杂,这对视觉检测系统提出了较高的要求。
 官方公众号
官方公众号 官方抖音号
官方抖音号Copyright © 2022 东莞康耐德智能控制有限公司版权所有.机器视觉系统 粤ICP备2022020204号-1 联系我们 | 网站地图