服务热线
0769-28680919
153-2293-3971 / 177-0769-6579
康耐德智能晶圆光刻胶涂布缺陷机器视觉检测系统,是半导体前道工序中实现高精度、高一致性质量控制的核心装备。光刻胶涂布的均匀性直接决定了光刻分辨率与良率,任何微米级甚至纳米级的缺陷都可能导致芯片失效。
成像系统
这是系统的“眼睛”,旨在捕捉高对比度、高分辨率的胶面缺陷特征。
光源设计:光刻胶多为透明或半透明薄膜,常规明场照明难以捕捉边缘或内部缺陷。系统常采用多角度多光谱照明:
暗场照明:利用散射光突出颗粒、划伤、气泡等轮廓型缺陷。
分光光度法:通过特定波长(如UV或特定RGB波段)测量膜厚干涉条纹,检测膜厚不均。
DIC(微分干涉相差)技术:利用诺曼斯基棱镜,将光程差转化为立体浮雕感,对“水波纹”、条纹等细微高度变化极其敏感。
图像采集:采用高帧率、高分辨率的线阵或面阵相机。对于12英寸晶圆,通常使用线阵扫描方式,配合晶圆旋转或直线运动,获取完整的2D或3D形貌图像。
缺陷分类与算法模型
针对光刻胶涂布特有的缺陷,系统需建立专门的分类器。常见缺陷包括:
边缘堆积:晶圆边缘光刻胶隆起(常见于旋涂工艺),影响边缘曝光区域。
条纹/条纹痕:由于气流扰动或旋转加速度变化导致的放射状或同心圆纹路。
气泡/空洞:胶液中的气泡破裂后形成的无胶区或针孔。
回溅:在晶圆背面或边缘的光刻胶溅射污染。
颗粒污染:附着在胶膜表面或内部的异物。
算法演进:
传统算法:基于灰度阈值、形态学及特征工程(如HOG、LBP)进行缺陷分割。优点是可解释性强、算力消耗低,适用于特征明确的周期性缺陷。
深度学习(当前主流):
利用语义分割网络(如U-Net、DeepLabV3+)实现像素级缺陷检出,对低对比度的微小缺陷(<1μm)敏感度极高。
利用异常检测模型(如PatchCore、DRAEM)解决光刻胶缺陷样本不平衡问题(良品极多,缺陷极少),通过对比无缺陷模板识别异常区域。
光学关键尺寸与膜厚测量
现代系统往往集成了光学膜厚测量功能,而不仅仅是缺陷检测。
光谱反射法:通过分析特定区域的光谱反射率,实时计算光刻胶的厚度分布。如果检测到某区域膜厚超出工艺窗口(±1%),即使外观无缺陷,也会被判定为“涂布不均”并予以剔除。
技术挑战与前沿趋势
厚度与缺陷解耦:对于ArF浸没式光刻或EUV光刻使用的超薄光刻胶(厚度<100nm),传统光学视觉难以区分“无缺陷但厚度异常”与“物理形貌缺陷”。当前前沿研究结合相干层析成像进行三维体检测。
AI大模型应用:利用视觉大模型进行零样本缺陷分类,将人工复判率降低90%以上;同时通过多模态数据分析,将检测图像与涂布机实时参数(转速、温度、排风量)关联,快速定位工艺根因。
康耐德智能晶圆光刻胶涂布检测系统,本质上是精密光学、亚像素级图像算法、高速运动控制与半导体工艺知识的深度融合。其价值不仅在于拦截不良品,更在于通过数据驱动实现涂布工艺的精准优化。
 康耐德智能晶圆光刻胶涂布缺陷机器视觉检测系统
2026-04-19
康耐德智能晶圆光刻胶涂布缺陷机器视觉检测系统
2026-04-19
康耐德智能晶圆光刻胶涂布缺陷机器视觉检测系统,是半导体前道工序中实现高精度、高一致性质量控制的核心装备。光刻胶涂布的均匀性直接决定了光刻分辨率与良率,任何微米级甚至纳米级的缺陷都可能导致芯片失效。
 康耐德智能晶圆二维码机器视觉识别系统
2026-04-19
康耐德智能晶圆二维码机器视觉识别系统
2026-04-19
在半导体制造中,由于晶圆是高度洁净、价值极高的载体,且随着制程微缩(如5nm、3nm),晶圆表面的特征极度精细,因此这套识别系统面临着普通二维码识别系统完全不同的技术挑战。
 晶圆字符机器视觉识别系统
2026-04-12
晶圆字符机器视觉识别系统
2026-04-12
晶圆字符机器视觉识别系统是半导体制造过程中一个非常关键且技术难度较高的自动化检测设备。它的核心任务是在高反射、高纹理背景的晶圆表面上,准确识别出激光刻印或光刻形成的字符(包括字母、数字、批次号、二维码等),用于追溯生产历史、工艺控制和良率分析。
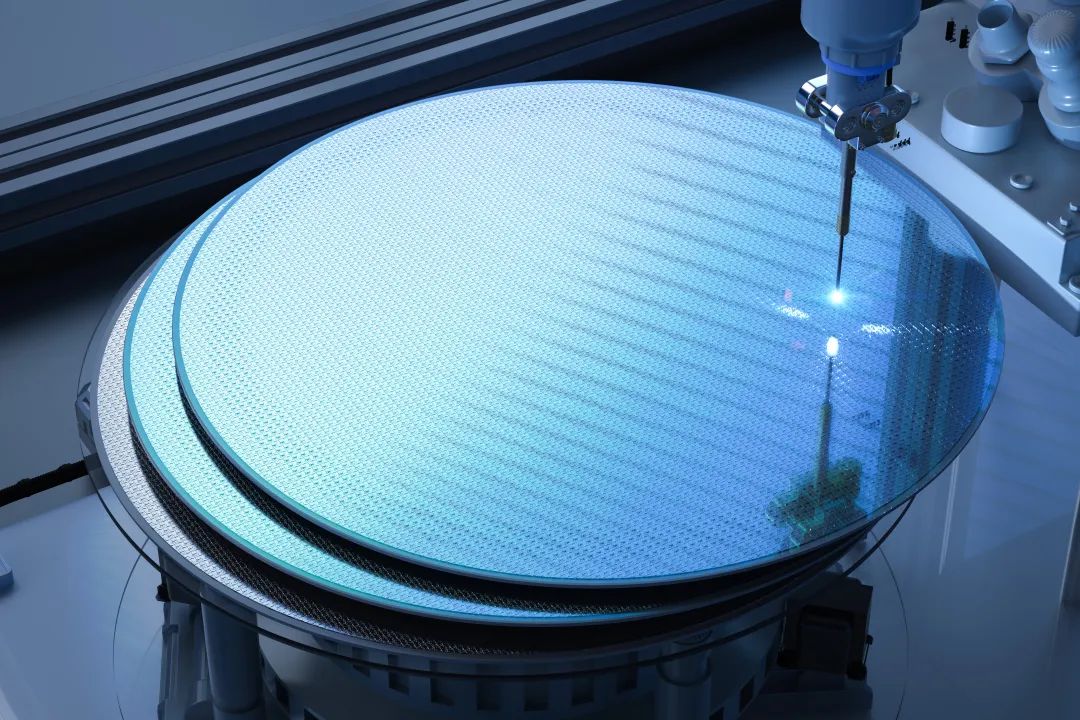 晶圆缺陷标记机器视觉读取系统
2026-04-12
晶圆缺陷标记机器视觉读取系统
2026-04-12
晶圆缺陷标记机器视觉读取系统是一种应用于半导体制造过程中的高精度自动化光学检测设备或模块。其主要目的是在晶圆流片(制造)过程中或完成后,利用机器视觉技术自动识别、读取和分析晶圆表面由人工或前道设备标记的缺陷位置信息(通常是墨点或激光微刻)。
 官方公众号
官方公众号 官方抖音号
官方抖音号Copyright © 2022 东莞康耐德智能控制有限公司版权所有.机器视觉系统 粤ICP备2022020204号-1 联系我们 | 网站地图