服务热线
0769-28680919
153-2293-3971 / 177-0769-6579
晶圆刻蚀残留检测是半导体制造良率控制的关键环节。由于刻蚀残留缺陷(如未刻透的氧化层、金属残留、聚合物残留)尺寸极小(纳米至微米级),且背景纹理复杂,传统的基于规则或简单模板匹配的机器视觉系统往往难以胜任。

检测能力与缺陷类型:
可检测的刻蚀相关缺陷
刻蚀残留物(Etch Residuals):反应生成物、金属残留
刻蚀不足/过度:图案未完全刻蚀或刻蚀过深导致的短路/断路
侧壁垂直度偏差:影响电路性能的关键指标
腐蚀缺陷:刻蚀后的化学腐蚀痕迹
图案缺陷:桥接、残缺、缺失结构
技术参数:
检测精度:可达亚微米级(<1μm),先进系统可达20μm分辨率(可选1.5μm)
检测速度:50-180片晶圆/小时(wph),取决于应用需求
检测范围:晶圆正面、背面、边缘全方位检测
关键难点与对策:
在晶圆厂实际部署时,仅靠算法是不够的,必须解决以下工程难题:
1. 小尺寸缺陷的检测(亚像素精度)
难点:刻蚀残留可能只有几百纳米,在光学图像上仅占几个像素甚至亚像素。
对策:
超分辨率重建:在预处理阶段使用深度学习模型对 ROI(感兴趣区域)进行超分重建。
多尺度特征融合:在检测网络中引入 FPN(特征金字塔),让网络同时关注全局纹理和局部微小异常。
2. 晶圆背景纹理干扰
难点:晶圆表面本身有电路图形(如金属线、沟槽),这些图形在视觉上与“残留”相似(都有明暗变化)。
对策:
设计规则检查(DRC)融合:将视觉检测与 CAD 设计数据对齐。算法通过导入 GDSII 设计图,先“屏蔽”掉设计上的正常图形区域,仅在“无图形区域”或“图形边界”搜索残留。例如,刻蚀残留通常出现在深槽底部或大块区域的边缘,结合设计数据可以显著降低误报。
3. 实时性与吞吐量
难点:一片 300mm 晶圆的全检数据量可达几十到上百 GB,处理时间需控制在几分钟以内,以满足 Fab 厂的产能要求(WPH,每小时晶圆处理数)。
对策:
GPU/NPU 加速:采用并行计算架构,将图像分块后送入多 GPU 集群处理。
先粗检后精检:采用级联检测策略。第一阶段用轻量级网络快速筛选出可疑坐标;第二阶段针对可疑坐标,调用高精度模型或更高倍率的镜头进行复判。
技术发展趋势:
AI驱动:深度学习自动识别罕见缺陷,降低人工标注依赖
电子束普及:利用电子束波长优势(<0.1nm)实现原子级成像
多模态融合:光学+电子束+X射线数据融合,覆盖全缺陷类型
原位检测:刻蚀设备内嵌检测模块,缩短良率反馈周期
该系统作为半导体制造的"质量守门人",通过高精度、高效率的非接触式检测,有效提升芯片良率,降低制造成本,是保障摩尔定律持续推进的关键技术之一。
 晶圆刻蚀残留机器视觉检测系统
2026-05-03
晶圆刻蚀残留机器视觉检测系统
2026-05-03
晶圆刻蚀残留检测是半导体制造良率控制的关键环节。由于刻蚀残留缺陷(如未刻透的氧化层、金属残留、聚合物残留)尺寸极小(纳米至微米级),且背景纹理复杂,传统的基于规则或简单模板匹配的机器视觉系统往往难以胜任。
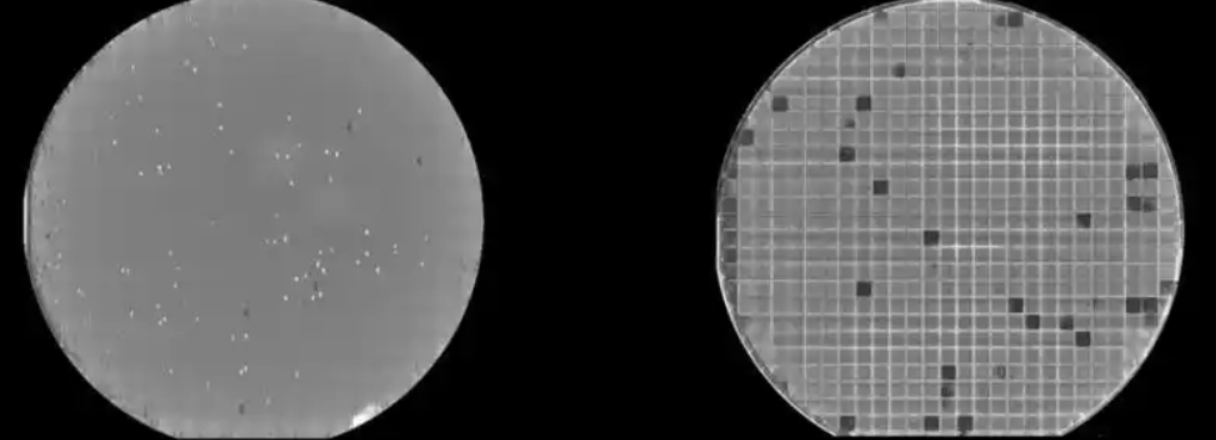 晶圆显影缺陷机器视觉检测系统
2026-05-03
晶圆显影缺陷机器视觉检测系统
2026-05-03
晶圆显影缺陷机器视觉检测系统主要用于显影后检查(ADI, After Develop Inspection),这是光刻工艺中的关键质量控制环节。该系统能够在显影工序完成后,自动检测光刻胶图形的缺陷,包括显影不完全、残留、桥接、缺失图案等问题。
 康耐德智能显示模组玻璃破片视觉检测系统
2026-05-03
康耐德智能显示模组玻璃破片视觉检测系统
2026-05-03
显示模组作为现代电子设备的核心显示单元,广泛应用于消费电子、车载显示、工业控制、医疗设备、智能穿戴等领域,而玻璃作为显示模组的核心承载部件(包括盖板玻璃、Cell玻璃、触控玻璃等),其完整性直接决定显示效果、触控性能与产品使用寿命。
 输液瓶液位高度机器视觉检测系统
2026-04-24
输液瓶液位高度机器视觉检测系统
2026-04-24
输液瓶(通常为玻璃或聚丙烯材质,透明或半透明)液位的检测,主要难点在于液体透明、反光、以及液体与空气的分界线(月牙面)特征不明显。
 官方公众号
官方公众号 官方抖音号
官方抖音号Copyright © 2022 东莞康耐德智能控制有限公司版权所有.机器视觉系统 粤ICP备2022020204号-1 联系我们 | 网站地图