服务热线
0769-28680919
153-2293-3971 / 177-0769-6579
晶圆金属线(互连线)的短路检测,是半导体制造中良率控制的关键环节。随着制程工艺向纳米级(7nm、5nm甚至更先进)发展,金属线宽度仅为几十纳米,间距极小,传统的自动光学检测面临巨大挑战。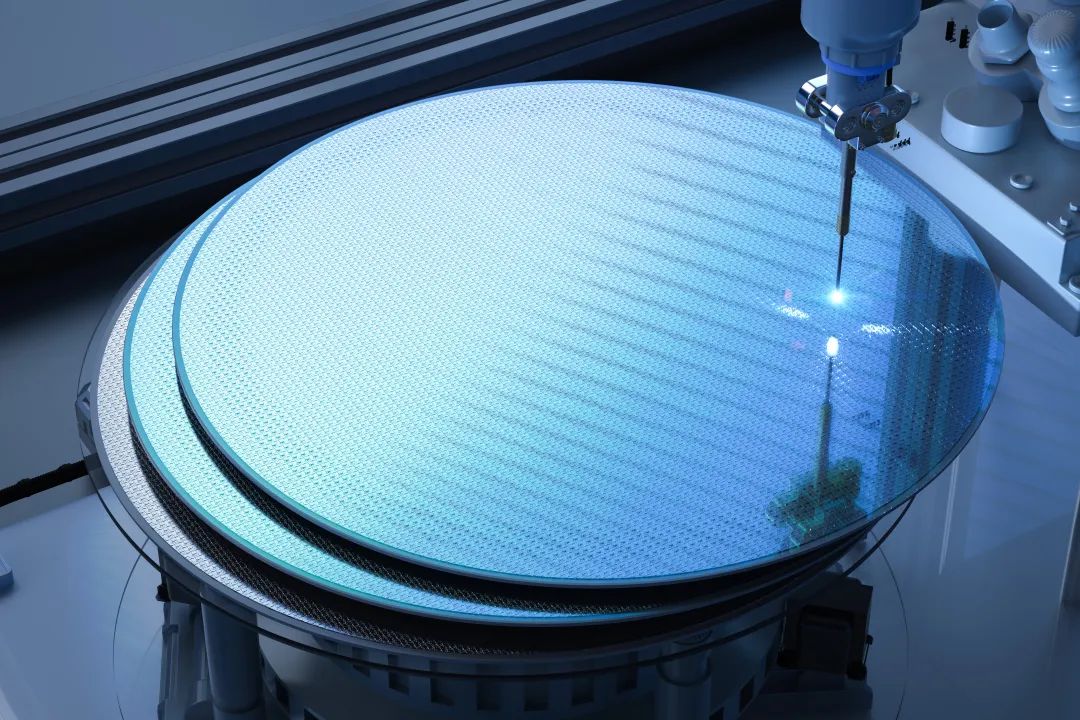
一、 核心挑战:为什么难?
在晶圆缺陷检测中,金属线短路(Bridge)属于致命缺陷。检测难点在于:
纳米级精度 vs. 大视场:需要在整个300mm(12英寸)晶圆上,发现尺寸在纳米级(<100nm)的微小桥接。
复杂的背景噪声:晶圆表面金属线排布极其密集,存在颜色差异、晶粒纹理、化学机械抛光不均带来的干扰,容易产生“假缺陷”(Overkill)。
光学衍射极限:当金属线宽小于光学分辨率极限(如使用明场显微镜时),传统光学成像无法直接“看清”短路点,只能依靠缺陷散射光或逻辑比对。
二、 成像硬件:光学系统设计
对于在线检测(Inline Inspection),主流方案并非直接“看到”短路,而是通过光学特性变化来推断。
1. 明场与暗场结合
UV-DIC(紫外微分干涉差):利用短波长(深紫外,如266nm)提高分辨率。DIC技术能将金属线表面的微小高度变化或边缘梯度转化为强烈的明暗对比,对于检测金属残留导致的桥接非常有效。
暗场散射:短路点通常是一个不规则的微小“金属须”或残留物。暗场照明下,平坦的金属线表面反射光进入物镜较少,而短路点会产生强烈的散射光(亮点),形成高对比度。
2. 多角度/多光谱成像
多通道检测:使用不同角度(正入射、斜入射)和不同波长的光源。金属对不同波长的反射率不同,通过多光谱图像融合,可以凸显异常区域的材质变化。
3. 电子束检测
当光学检测无法分辨时,电子束检测被用作补充或抽检。虽然速度慢,但分辨率极高,且能检测“隐藏”短路(如金属线下方或内部的桥接),还能通过电压衬度检测电路逻辑短路。
三、 核心算法:从图像到缺陷
单纯依靠图像灰度阈值分割,已无法满足先进制程的需求。现代系统采用图像比对与深度学习相结合的方式。
1. 基于设计的 Die-to-Die 与 Die-to-Database 比对
这是半导体检测的基石。
Die-to-Die:假设同一晶圆上相邻的芯片(Die)是完美的。将当前Die的图像与相邻Die对齐后相减,差异处即为缺陷。这种方法对晶圆工艺波动不敏感,但对“重复性缺陷”(即每个Die同一位置都有的设计缺陷)无效。
Die-to-Database:将拍摄图像与原始的GDS/OASIS设计版图进行高精度配准。这种方法能识别出“非设计”的金属连接(即短路)。
2. 深度学习语义分割
传统算法难以区分“工艺波动”和“真实短路”。
基于CNN的缺陷检测:训练深度卷积神经网络(如U-Net变体)对图像进行像素级分割。
关键点:需要大量的标注数据(含真实短路、假缺陷、正常金属线)。
优势:能够学习金属线的拓扑结构,即使短路点对比度极低,模型也能通过上下文(如两条本应平行的线突然出现了连通区域的形态)进行判断。
3. 高精度配准与差分
深度学习辅助的亚像素级配准是降低误报的关键。由于晶圆在载物台移动中存在微小震动和伸缩,如果图像叠加不准,金属线边缘的轻微错位会被误判为短路。需要利用深度学习提取金属线特征点,实现纳米级配准。
五、 当前技术趋势与痛点
从2D走向3D:
先进封装(如HBM、Chiplet)中的金属线(RDL重布线层)具有大高宽比。单纯的2D图像无法区分“表面异物”和“金属桥接”。3D白光干涉或激光扫描共聚焦正在被引入,通过获取高度信息,判断金属线之间是否存在物理连接。
人工智能的挑战:未知缺陷
深度学习擅长识别“见过的”短路形态。对于全新的、未曾在训练集中出现的工艺缺陷,容易出现漏检。
解决方案:异常检测模型,不学习缺陷长什么样,而是学习“正常金属线”长什么样,任何偏离正常流形的区域都被报警。
计算负载
一片12英寸晶圆的数据量可达TB级别。如何在保证检测精度的同时,实现每小时处理数十片晶圆的吞吐量,对硬件加速提出了极高要求。
构建一个高效的晶圆金属线短路机器视觉检测系统,核心在于:
硬件上:采用深紫外光+多模态(明暗场结合) 成像,突破衍射极限,获取高信噪比的原始图像。
算法上:必须结合设计版图信息,通过高精度配准区分设计与制造差异,并利用深度学习对极微小的形态异常进行语义理解。
系统上:需要构建高速光学初筛+高精度SEM复检的闭环,以平衡产能与精度。
 晶圆缺失图案机器视觉检测系统
2026-05-10
晶圆缺失图案机器视觉检测系统
2026-05-10
晶圆缺失图案(即图案化晶圆)的机器视觉检测,是半导体制造中确保良率的核心环节。它利用光学、图像处理和AI技术,在纳米级尺度上识别晶圆表面的各种图案缺陷。
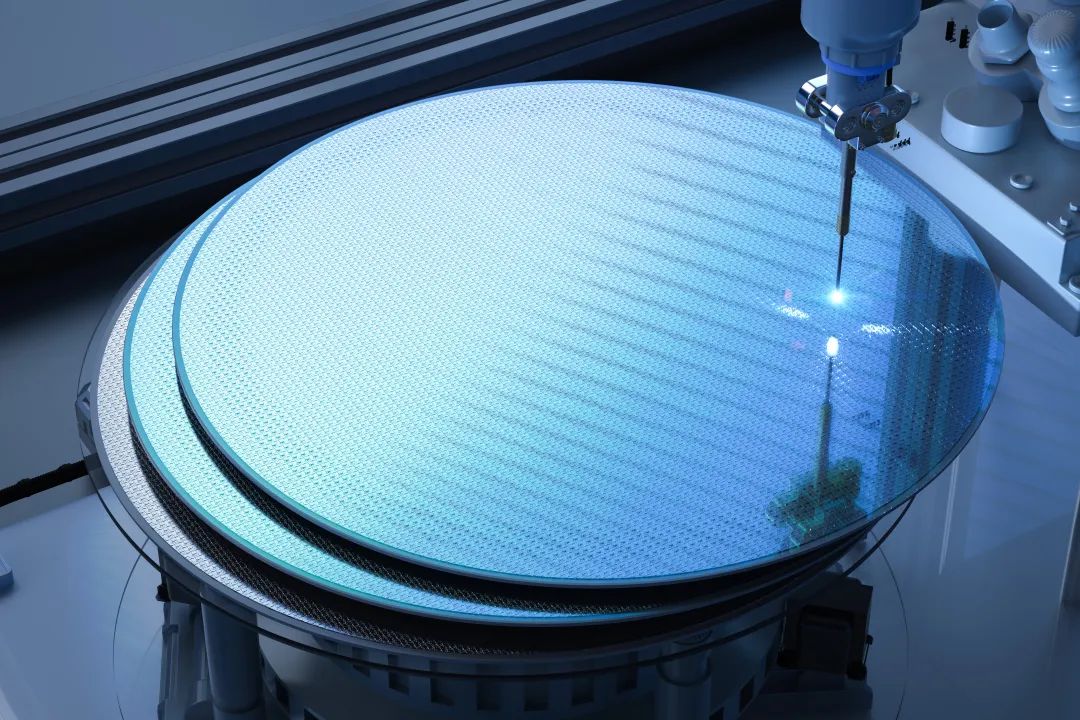 晶圆金属线短路机器视觉检测系统
2026-05-10
晶圆金属线短路机器视觉检测系统
2026-05-10
晶圆金属线(互连线)的短路检测,是半导体制造中良率控制的关键环节。随着制程工艺向纳米级(7nm、5nm甚至更先进)发展,金属线宽度仅为几十纳米,间距极小,传统的自动光学检测面临巨大挑战。
 晶圆刻蚀残留机器视觉检测系统
2026-05-03
晶圆刻蚀残留机器视觉检测系统
2026-05-03
晶圆刻蚀残留检测是半导体制造良率控制的关键环节。由于刻蚀残留缺陷(如未刻透的氧化层、金属残留、聚合物残留)尺寸极小(纳米至微米级),且背景纹理复杂,传统的基于规则或简单模板匹配的机器视觉系统往往难以胜任。
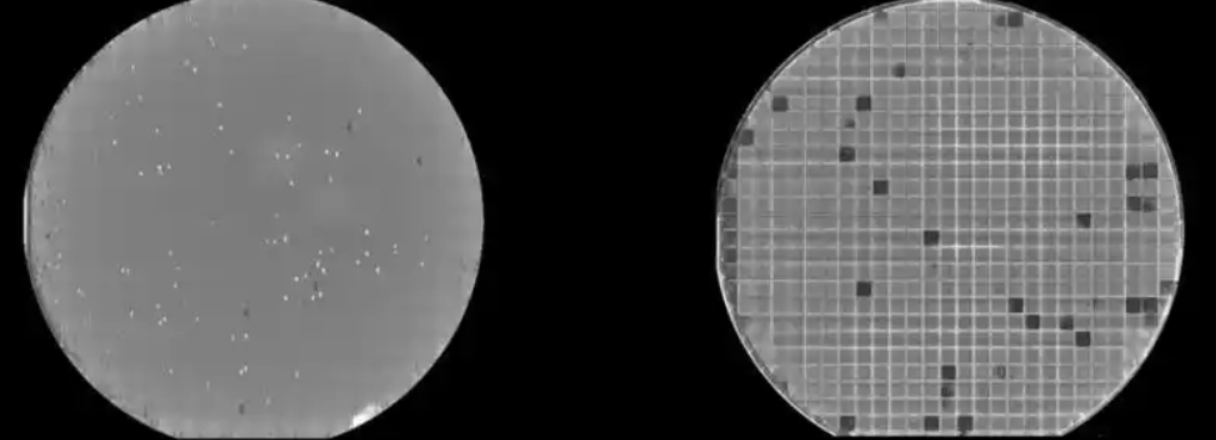 晶圆显影缺陷机器视觉检测系统
2026-05-03
晶圆显影缺陷机器视觉检测系统
2026-05-03
晶圆显影缺陷机器视觉检测系统主要用于显影后检查(ADI, After Develop Inspection),这是光刻工艺中的关键质量控制环节。该系统能够在显影工序完成后,自动检测光刻胶图形的缺陷,包括显影不完全、残留、桥接、缺失图案等问题。
 官方公众号
官方公众号 官方抖音号
官方抖音号Copyright © 2022 东莞康耐德智能控制有限公司版权所有.机器视觉系统 粤ICP备2022020204号-1 联系我们 | 网站地图